器件的基础性原材料。 极高纯度的半导体经过拉晶、切片等工序制备成为晶圆,晶圆经过一系列设备当中。 晶圆材料经历了 60 余年的技术演进和产业高质量发展,形成了当今以硅为主、新型半导体材料为补充的产业局面。
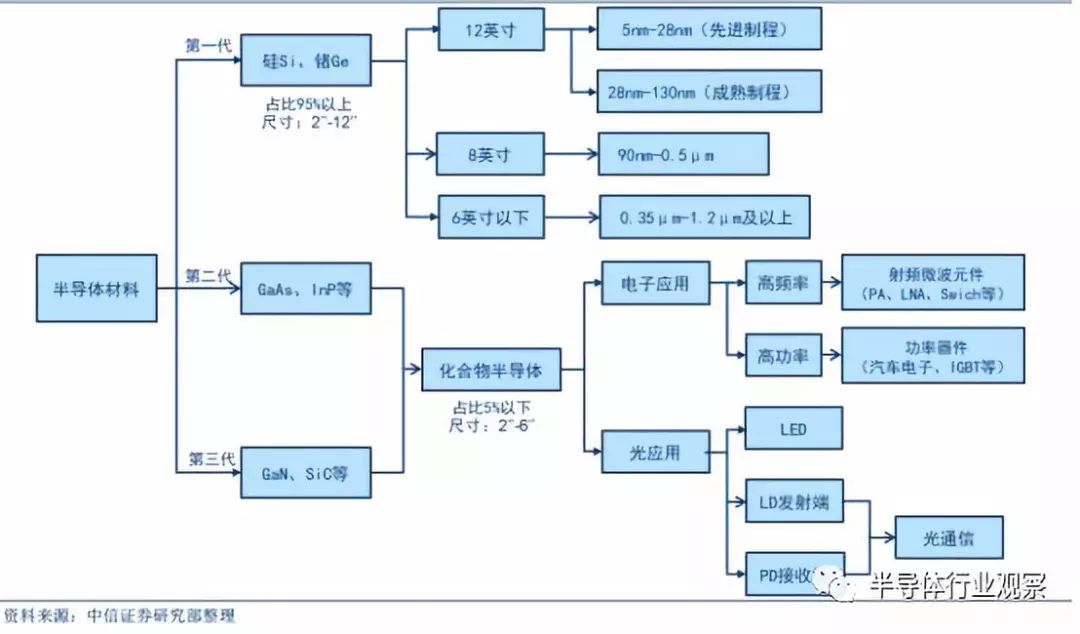
20 世纪 50 年代,锗(Ge)是最早采用的半导体材料,最先用于分立器件中。集成电路的产生是半导体产业向前迈进的重要一步, 1958 年 7 月,在德克萨斯州达拉斯市的,杰克·基尔比制造的第一块集成电路是采用一片锗半导体材料作为衬造的。
但是锗器件的耐高温和抗辐射性能存在短板,到 60 年代后期逐渐被硅(Si) 器件取代。 硅储量极其丰富,提纯与结晶工艺成熟, 并且氧化形成的二氧化硅(SiO2)薄膜绝缘性能好,使得器件的稳定性与可靠性大为提高, 因而硅慢慢的变成了应用最广的一种半导体材料。半导体器件产值来看,全球 95%以上的半导体器件和 99%以上的集成电路采用硅作为衬底材料。
2017 年全球半导体市场规模约 4122 亿美元,而化合物半导体市场规模约 200亿美元,占比 5%以内。 从晶圆衬底市场规模看, 2017 年硅衬底年销售额 87 亿美元, GaAs衬底年销售额约 8 亿美元。 GaN 衬底年销售额约 1 亿美元, SiC 衬底年销售额约 3 亿美元。硅衬底销售额占比达 85%+。 在 21 世纪,它的主导和核心地位仍不会动摇。但是 Si 材料的物理性质限制了其在光电子和高频、 高功率器件上的应用。

20 世纪 90 年代以来,以砷化镓(GaAs)、磷化铟(InP)为代表的第二代半导体材料开始崭露头脚。 GaAs、 InP 等材料适用于制作高速、高频、大功率以及发光电子器件,是制作高性能微波、毫米波器件及发光器件的优良材料,大范围的应用于卫星通讯、移动通讯、光通信、 GPS 导航等领域。但是 GaAs、InP 材料资源稀缺,价格昂贵,并且还有毒性,能污染自然环境, InP 甚至被认为是可疑致癌物质,这些缺点使得第二代半导体材料的应用具有很大的局限性。
第三代半导体材料最重要的包含 SiC、 GaN 等,因其禁带宽度(Eg)大于或等于 2.3 电子伏特(eV),又被称为宽禁带半导体材料。 和第一代、第二代半导体材料相比,第三代半导体材料具备高热导率、高击穿场强、高饱和电子漂移速率和高键合能等优点,能够完全满足现代电子技术对高温、高功率、高压、高频以及抗辐射等恶劣条件的新要求,是半导体材料领域最有前景的材料,在国防、航空、航天、石油勘探、光存储等领域有着重要应用前景,在宽带通讯、太阳能、汽车制造、半导体照明、智能电网等众多战略行业能够更好的降低 50%以上的能量损失,最高可以使装备体积减小 75%以上,对人类科技的发展具有里程碑的意义。
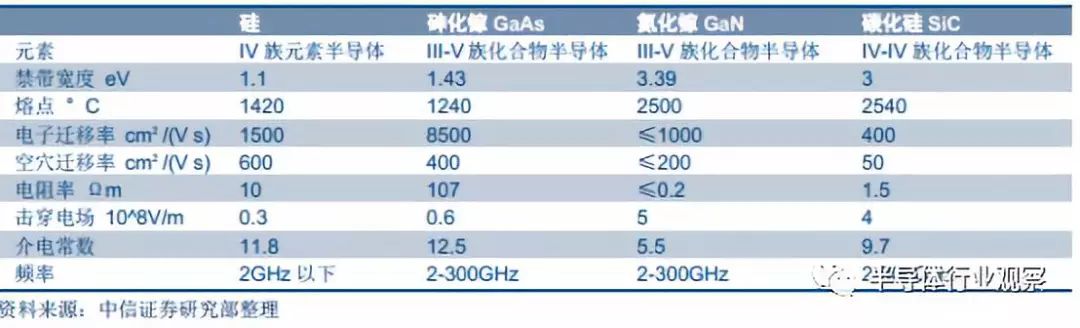
化合物半导体是指两种或两种以上元素形成的半导体材料, 第二代、第三代半导体多属于这一类。 按照元素数量可大致分为二元化合物、三元化合物、四元化合物等等,二元化合物半导体按照组成元素在化学元素周期表中的位置还可分为 III-V 族、 IV-IV 族、 II-VI 族等。 以砷化镓(GaAs)、氮化镓(GaN)、碳化硅(SiC)为代表的化合物半导体材料慢慢的变成了继硅之后发展最快、应用最广、产量最大的半导体材料。 化合物半导体材料具备优越的性能和能带结构:
、功率器件等制造,具有很大发展潜力;硅器件则多用于逻辑器件、存储器等,相互之间具有无法替代性。
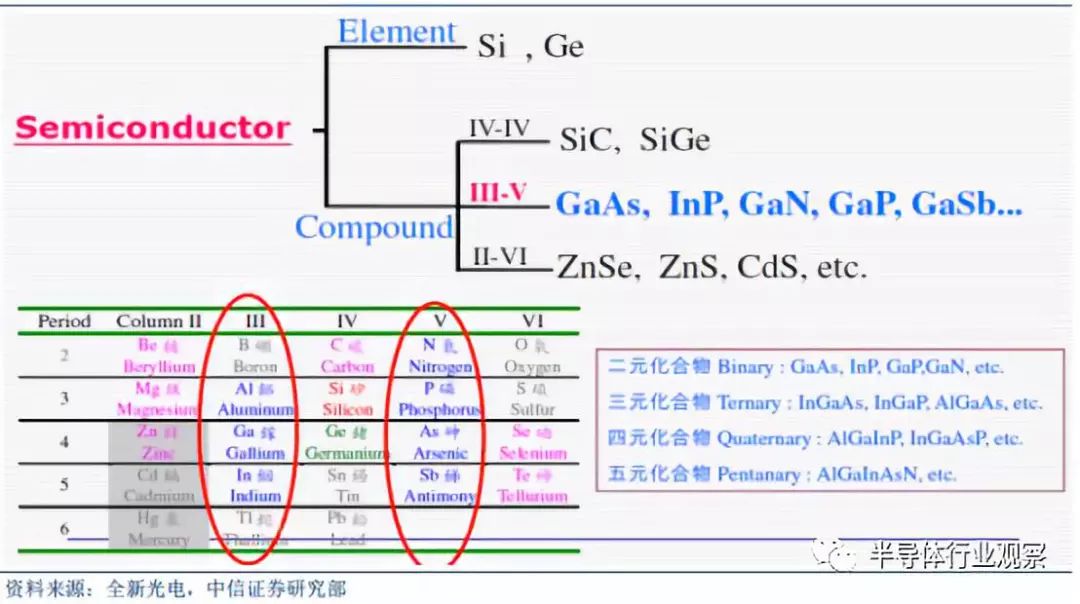
)是由半导体单晶材料制造而成的晶圆片,衬底可以立即进入晶圆制造环节生产半导体器件,也能够直接进行外延工艺加工生产外延片。外延(epitaxy)是指在单晶衬底上生长一层新单晶的过程,新单晶可以与衬底为同一材料,也可以是不一样的材料。 外延可以生产种类更多的材料,使得器件设计有了更多选择。衬备的基本步骤如下:半导体多晶材料首先经过提纯、掺杂和拉制等工序制得单晶材料,以硅为例,硅砂首先提炼还原为纯度约 98%的冶金级粗硅,再经多次提纯,得到电子级高纯度多晶硅(纯度达 99.9999999%以上, 9~11 个 9),经过熔炉拉制得到单晶硅棒。单晶材料经过机械加工、化学处理、 表面抛光和质量
,获得符合一定标准(厚度、晶向、平整度、平行度和损伤层)的单晶抛光薄片。 抛光目的是进一步去除加工表面残留的损伤层,抛光片可直接用于制作器件,也可作为外延的衬底材料。

外延生长工艺目前业界最重要的包含 MOCVD(化学气相沉淀)技术和 MBE(分子束外延)技术两种。 例如,全新光电采用 MOCVD,英特磊采用 MBE 技术。

相比之下, MOCVD技术生长速率更快,更适合产业化大规模生产,而 MBE 技术在部分情况如 PHEMT 结构、Sb 化合物半导体的生产中更适合采用。 HVPE(氢化物气相外延)技术主要使用在于 GaN 衬底生产。 LPE(液相沉积)技术大多数都用在硅晶圆,目前已基本被气相沉积技术所取代。

硅晶圆尺寸最大达 12 寸, 化合物半导体晶圆尺寸最大为 6 英寸。 硅晶圆衬底主流尺寸为 12 英寸,约占全球硅晶圆产能 65%, 8 寸也是常用的成熟制程晶圆,全球产能占比 25%。GaAs 衬底主流尺寸为 4 英寸及 6 英寸; SiC 衬底主流供应尺寸为 2 英寸及 4 英寸; GaN 自支撑衬底以 2 英寸为主。

SiC 衬底目前尺寸已达 6 英寸, 8 英寸正在研发(II-VI 公司已制造出样品) 。而实际上主流采用的仍为 4 英寸晶圆。根本原因是(1)目前 6 英寸 SiC 晶圆大概是 4 英寸成本的 2.25倍,到 2020 年大概为 2 倍,在成本缩减上并没有大的进步,并且更换设备机台需要额外的资本支出, 6 英寸目前优势仅在生产效率上;(2) 6 英寸 SiC 晶圆相较于 4 英寸晶圆在品质上偏低,因而目前 6 英寸大多数都用在制造
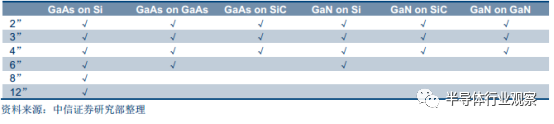
GaN 材料在自然界中缺少单晶材料,因而长期在蓝宝石、 SiC、 Si 等异质衬底上进行外延。 现今通过氢化物气相外延(HVPE)、氨热法可以生产 2 英寸、 3 英寸、 4 英寸的 GaN自支撑衬底。 目前商业应用中仍以异质衬底上的 GaN 外延为主, GaN 自支撑衬底在激光器上具有最大应用,可获得更高的发光效率及发光品质。
格局: 日厂把控, 寡头格局稳定。日本厂商占据硅晶圆 50%以上市场占有率。前五大厂商占据全球 90%以上份额。 其中,日本信越化学占比 27%、日本 SUMCO 占比 26%,两家日本厂商份额合计 53%,超过一半,中国***环球晶圆于 2016 年 12 月晶圆产业低谷期间收购美国 SunEdison 半导体,由第六晋升第三名,占比 17%,德国 Siltron
占比 13%,韩国 SK Siltron(原 LG Siltron, 2017年被 SK 集团收购) 占比 9%,与前四大厂商不同, SK Siltron 仅供应韩国客户。除此以外还有法国 Soitec、中国***台胜科、合晶、嘉晶等企业,份额比较小。各大厂商供应晶圆类别与尺寸上不一样,整体看来前三大厂商产品较为多样。 前三大厂商能够供应 Si 退火片、 SOI 晶片,其中仅日本信越能够供应 12 英寸 SOI 晶片。德国Siltronic、韩国 SK Siltron 不提供 SOI 晶片, SK Siltron 不供应 Si 退火片。而 Si 抛光片与Si 外延片各家尺寸基本没差别。

近 15 年来日本厂商始终占据硅晶圆 50%以上市场占有率。硅晶圆产能未发生明显区域性转移。 根据 Gartner, 2007 年硅晶圆市占率第一日本信越(32.5%)、第二日本 SUMCO(21.7%)、第三德国 Siltronic(14.8%) ; 2002 年硅晶圆市占率第一日本信越(28.9%)、第二日本 SUMCO(23.3%)、第三德国 Siltronic(15.4%) 。 近期市场比较大的变动是 2016年 12 月***环球晶圆收购美国 SunEdison,从第六大晋升第三大厂商。但日本厂商始终占据 50%+份额。
日本在 fab 环节竞争力衰落而材料环节从始至终保持领头羊。 20 世纪 80 年代中旬,日本半导体产业的世界份额曾经超过了 50%。日本在半导体材料领域的优势从上世纪延续而来,而晶圆制造竞争力明显减弱, 半导体 fab 环节出现了明显的区域转移。究其原因, fab 环节离需求端较近,市场变动大;但硅晶圆同质化程度高,新进入玩家要在客户有比较久的时间验证;且晶圆在晶圆代工中成本占比 10%以下,晶圆代工厂不愿为较小的价格差别冒险更换不成熟的产品。

博通联发科、苹果等厂商实力最强,大陆厂商海思崛起。 随着科学技术发展引领终端产品升级,AI 芯片等创新应用对 IC 产品需求逐步扩大,预计到 2020 年 AI 芯片市场规模将从 2016 年约 6 亿美元升至 26 亿美元, CAGR 达 43.9%,目前国内外 IC 设计厂商正积极布局 AI 芯片产业。英伟达是 AI 芯片市场领导者,AMD特斯拉正联合研发用于无人驾驶的 AI 芯片。对于国内厂商,华为海思于 2017 年 9 月率先推出麒麟 970 AI 芯片,目前已成功搭载入 P20等机型;比特大陆发布的全球首款张量加速计算芯片 BM1680 已成功运用于
矿机;寒武纪的 1A处理器、地平线的征程和旭日处理器也已崭露头角。IC 设计面向终端、面向市场成为必然,国内厂商优势显著。 IC 设计业以需求为导向,才可以更加好服务于下游客户。海思、展锐等移动处理芯片、基带芯片厂商依靠近些年中国智能手机市场爆发迅速崛起,跻身世界 IC 设计十强,海思芯片已全面应用到华为当中,三星、小米等厂商亦采用了自研芯片, 现今中国为全球最大的终端需求市场,因而国内IC 设计业有巨大发展优势。

代工制造方面,厂商 Capex 迅速增加,三星、台积电等巨头领衔。 从资本支出来看,目前全球先进制程芯片市场之间的竞争激烈,全球排名前三的
、台积电的Capex 均达到百亿美元级别, 2017 年分别为 440/120/108 亿美元,预计三星未来三年总Capex 接近 1100 亿美元,英特尔和台积电 2018 年 Capex 则预计分别达到 140 和 120 亿美元,均有较大幅度的增长,利于巨头通过研发先进制程技术和扩张产线来占领市场。从工艺制程来看,台积电走在行业前列,目前已大规模生产 10nm 制程芯片, 7nm 制程将于 2018年量产;中国大陆最为领先的代工厂商中芯国际目前具备 28nm 制程量产能力,而台积电早于 2011 年已具备 28nm 量产能力,相比之下大陆厂商仍有较大差距。

封测方面,未来高端制造+封测融合趋势初显,大陆厂商与台厂技术差距缩小。
技术目前已发展四代,在最高端技术上制造与封测已实现融合,其中台积电已建立起CoWoS 及 InFO 两大高阶封装ECO,并计划通过从龙潭延伸至中科将 InFO 产能扩增一倍,以满足苹果 A12 芯片的需求。
封测龙头日月光则掌握顶尖封装与微电子制造技术,率先量产 TSV/2.5D/3D 相关这类的产品,并于 2018 年 3 月与日厂TDK合资成立日月旸电子扩大 SiP布局。由于封装技术门槛相比来说较低,目前大陆厂商正快速追赶,与全球领先厂商的技术差距正逐步缩小,大陆厂商已基本掌握 SiP、 WLCSP、 FOWLP 等先进的技术,应用方面 FC、 SiP等封装技术已实现量产。

新一轮区域转移面向中国大陆。 尽管目前 IC 设计、制造、封测的顶级厂商主要位于美国、中国***。整体看来,半导体制造产业经历了美国——日本——韩台的发展历史: 1950s,半导体产业起源于美国, 1947 年
诞生, 1958 年集成电路诞生。 1970s,半导体制造由美国向日本转移。
是日韩产业高质量发展的重要切入点, 80s 日本已在半导体产业处于领头羊。 1990s,以 DRAM 为契机,产业转向韩国三星、海力士等厂商;晶圆代工环节则转向***,台积电、联电等厂商崛起。 2010s,智能手机、移动互联网爆发,物联网、大数据、云计算人工智能等产业快速成长。人口红利,需求转移或将带动制造转移,能预见中国大陆已然成为新一轮区域转移的目的地。
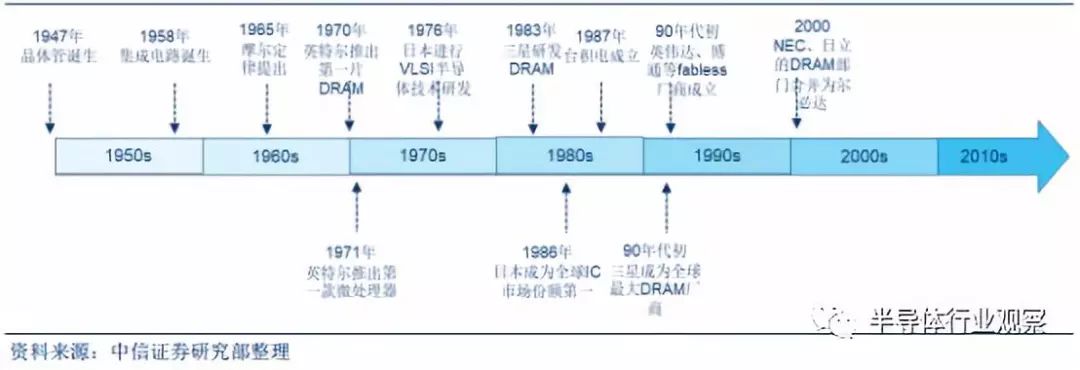
晶圆尺寸与工艺制程并行发展,每一制程阶段与晶圆尺寸相对应。 (1) 制程进步→晶体管缩小→晶体管密度成倍增加→性能提升。 (2) 晶圆尺寸增大→每片晶圆产出芯片数量更多→效率提升→成本降低。 目前 6 吋、 8 吋硅晶圆生产设备普遍折旧完毕,生产所带来的成本更低,主要生产 90nm 以上的成熟制程。 部分制程在相邻尺寸的晶圆上都有产出。 5nm 至 0.13μm则采用 12 英寸晶圆,其中 28nm 为分界区分了先进制程与成熟制程,根本原因是 28nm 以后引入 FinFET 等新设计、新工艺,晶圆制造难度大大提升。
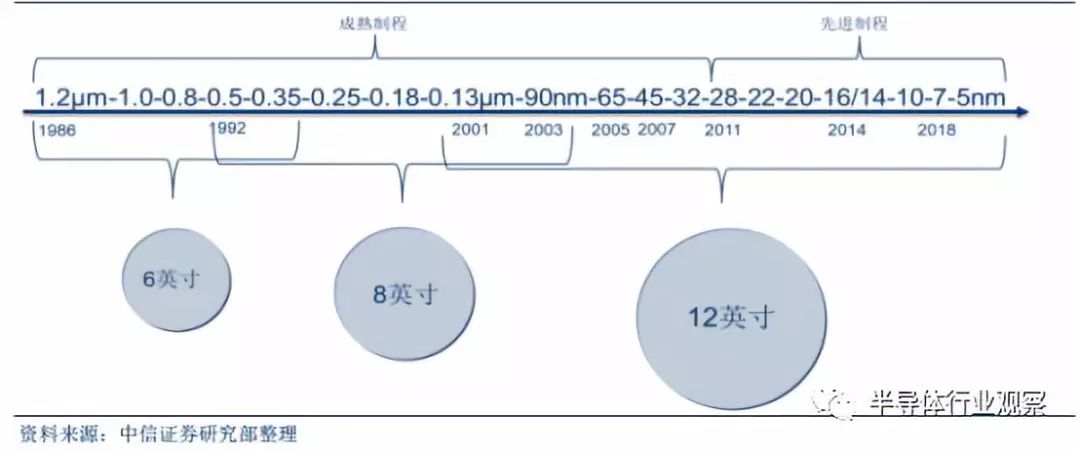
晶圆需求总量来看, 12 英寸 NAND 及 8 英寸市场为核心驱动力。 存储用 12 寸硅晶圆占比达 35%为最大, 8 寸及 12 英寸逻辑次之。 以产品销售额来看,全球集成电路产品中,存储器占比约 27.8%,逻辑电路占比 33%,
电路分别占 21.9%和 17.3%。依照我们预测,全球 2016 年下半年 12 寸硅晶圆需求约 510 万片/月,其中用于逻辑芯片的需求 130 万片/月,用于 DRAM 需求 120 万片/月,用于 NAND 需求 160 万片/月,包括 NORFlash、 CIS 等其他需求 100 万片/月; 8 寸硅晶圆需求 480 万片/月,按面积折算至 12 寸晶圆约 213 万片/月, 6 寸以下晶圆需求约当 12 寸 62 万片/月。

由此估算,包括 NAND、 DRAM在内用于存储市场的 12 寸晶圆需求约占总需求 35%, 8 寸晶圆需求约占总需求 27%,用于逻辑芯片的 12 寸晶圆需求约占 17%。需求上看,目前存储器贡献晶圆需求最多, 8 寸中低端应用其次。

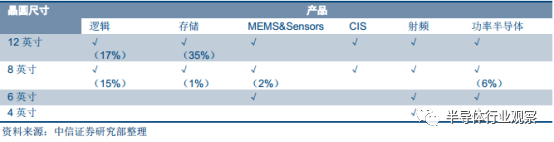
下游具体应用来看, 12 英寸 20nm 以下先进制程性能强劲, 大多数都用在移动电子设备、 高性能计算等领域, 包括智能手机主芯片、计算机
、高性能FPGAASIC等。14nm-32nm 先进制程应用于包括 DRAM、 NAND Flash 存储芯片、中低端处理器芯片、影像处理器、数字电视机顶盒等应用。12 英寸 45-90nm 的成熟制程大多数都用在性能需求略低,对成本和生产效率要求高的领域,例如手机基带、 WiFi、 GPS、蓝牙

化合物半导体晶圆供给厂商格局:日美德主导,寡占格局。衬底市场: 高技术门槛导致化合物半导体衬底市场寡占,日本、美国、德国厂商主导。GaAs 衬底目前已日本住友
、德国 Freiberg、美国 AXT、日本住友化学四家占据,四家份额超 90%。住友化学于 2011 年收购日立电缆(日立金属)的化合物半导体业务,并于 2016年划至子公司 Sciocs。 GaN 自支撑衬底目前主要由日本三家企业住友电工、三菱化学、住友化学垄断,占比合计超 85%。 SiC 衬底龙头为美国 Cree(Wolfspeed 部门),市场占比超三分之一,其次为德国 SiCrystal、美国 II-VI、美国 Dow Corning,四家合计份额超 90%。近几年中国也出现了具备一定量产能力的 SiC 衬造商,如北京天科合达半导体股份有限公司。

外延生长市场中,英国 IQE 市场占比超 60%为绝对龙头。 英国 IQE 及中国***全新光电两家份额合计达 80%。 外延生长最重要的包含 MOCVD(化学气相沉淀)技术和 MBE(分子束外延)技术两种。例如, IQE、 全新光电均采用 MOCVD,英特磊采用 MBE 技术。 HVPE(氢化物气相外延)技术主要使用在于 GaN 衬底的生产。


化合物半导体晶圆代工领域稳懋为第一大厂商,占比 66%,为绝对龙头。 第二、第三为宏捷科技 AWSC、 环宇科技 GCS,占比分别为 12%、 9%。国内设计推动代工, 大陆化合物半导体代工龙头呼之欲出。 目前国内 PA 设计已经涌现了锐迪科 RDA、 唯捷创芯 vanchip、汉天下、 飞骧科技等公司。

市场中的低端应用。 三安光电目前以LED应用为主,有望在化合物半导体代工填补国内空白,其募投产线 片/月产能,成为大陆第一家规模量产 GaAs/GaN 化合物晶圆代工企业。化合物半导体晶圆下游应用拆分:性能独特,自成体系化合物半导体下游具体应用主要可分为两大类:
器件和电子设备。 光学器件包括LED 发光二极管、 LD 激光二极管、 PD 光接收器等。 电子器件包括 PA
、 LNA低噪声放大器、射频开关、数模转换、微波单片 IC、功率半导体器件、霍尔元件等。 对于GaAs 材料而言, SC GaAs(单晶砷化镓) 主要使用在于光学器件, SI GaAs(半绝缘砷化镓)主要使用在于电子器件。

光学器件中, LED 为占比最大一项, LD/PD、 VCSEL 成长空间大。 Cree 大约 70%收入来自 LED,其余来自功率、射频、 SiC 晶圆。 SiC 衬底 80%的市场来自二极管,在所有宽禁带半导体衬底中, SiC 材料是最为成熟的。不同化合物半导体材料制造的 LED 对应不同波长光线: GaAs LED 发红光、绿光, GaP 发绿光, SiC 发黄光, GaN 发蓝光,应用 GaN蓝光 LED 激发黄色荧光材料可以制造白光 LED。此外 GaAs 可制造
光 LED,常见的应用于遥控器红外发射, GaN 则可以制造紫外光 LED。 GaAs、 GaN 分别制造的红光、蓝光激光发射器能应用于 CD、 DVD、蓝光光盘的读取。
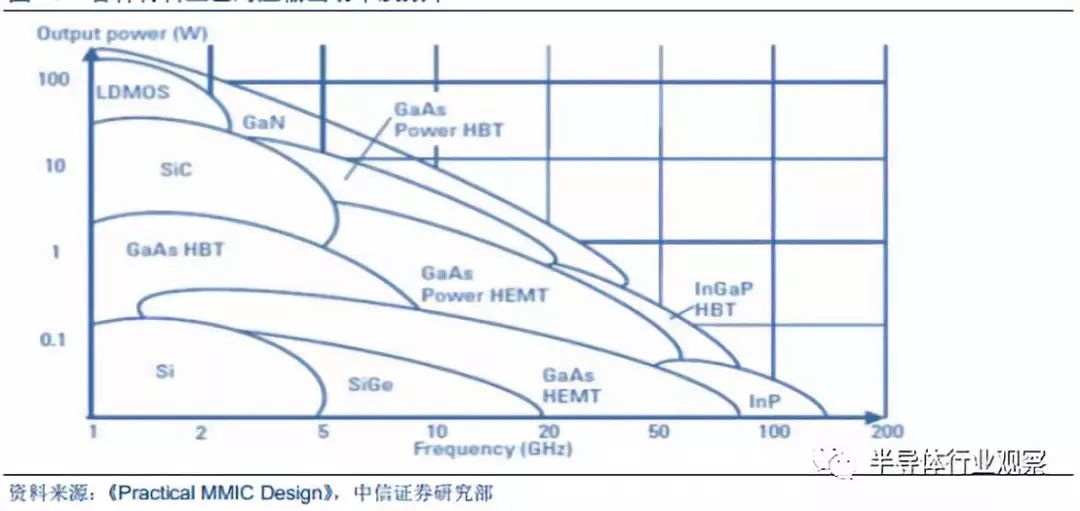
电子器件中,主要为射频和功率应用。 GaN on SiC、 GaN 自支撑衬底、 GaAs 衬底、GaAs on Si 主要使用在于射频半导体(射频前端 PA 等); 而 GaN on Si 以及 SiC 衬底主要使用在于功率半导体(
GaN 由于功率密度高,在基站大功率器件领域具有独特优势。 相对于硅衬底来说, SiC衬底具有更加好的热传导特性,目前业界超过 95%的 GaN 射频器件采用 SiC 衬底,如 Qorvo采用的正是基于 SiC 衬底的工艺,而硅基 GaN 器件可在 8 英寸晶圆制造,更具成本优势。在功率半导体领域, SiC 衬底与 GaN on Silicon 只在很小一部分领域有竞争。 GaN 市场大多是低压领域,而 SiC 在高压领域应用。 它们的边界大约是 600V。
智能手机核心芯片涉及先进制程及化合物半导体材料, 国产率低。 以目前国产化芯片已采用较多的华为手机为例可大致看出国产芯片的“上限” 。

CPU 目前华为海思可以独立设计,此外还包括小米松果等 fabless 设计公司, 但由于采用 12 英寸最先进制程,制造主要依赖中国***企业; DRAM、 NAND 闪存国内尚无相关公司量产;前端 LTE 模块、 WiFi 蓝牙模块采用了 GaAs 材料, 产能集中于 Skyworks、 Qorvo 等美国 IDM 企业和稳懋等中国***代工厂,中国大陆尚无砷化镓代工厂商;射频收发模块、
IC 可做到海思设计+foundry 代工,而充电控制 IC、 NFC 控制 IC 和气压、陀螺仪等传感器主要由欧美 IDM厂商提供。整体看来智能手机核心芯片国产率仍低,部分芯片如 DRAM、 NAND、射频模块等国产化几乎为零。以主流旗舰手机iPhoneX 为例可以大致看出中国大陆芯片厂商在全球供应链中的地位。 CPU 采用苹果自主设计+台积电先进制程代工, DRAM、 NAND 来自韩国/日本/美国 IDM厂商;基带来自高通设计+台积电先进制程代工;射频模块采用砷化镓材料,来自 Skyworks、Qorvo 等 IDM 厂商或博通+稳懋代工;模拟芯片、音频 IC、 NFC 芯片、触控 IC、影像传感器等均来自中国大陆以外企业,中国大陆芯片在苹果供应链中占比为零。而除芯片、屏幕以外的零部件大多有中国大陆供应商打入,甚至部分由大陆厂商独占。由此可见中国大陆芯片企业在全世界内竞争力仍低。

通信基站对国外芯片依赖程度极高,且以美国芯片企业为主。 目前基站系统主要由基带处理单元(BBU)及射频拉远单元(RRU)两部分所组成, 通常一台 BBU 对应多台 RRU 设备。 相比之下, RRU 芯片的国产化程度更低,对于国外依赖程度高。
这其中主要难点体现在 RRU 芯片器件涉及大功率射频场景,一般会用砷化镓或氮化镓材料,而中国大陆缺乏相应产业链。
美国厂商垄断大功率射频器件。 具体来看, 目前 RRU 设备中的 PA、 LNA、 DSA、 VGA等芯片主要是采用砷化镓或氮化镓工艺,来自 Qorvo、 Skyworks 等公司,其中氮化镓器件通常为碳化硅衬底,即 GaN on SiC。 RF
采用硅基及砷化镓工艺,主要厂商包括TIADIIDT等公司。以上厂商均为美国公司,因而通信基站芯片对美国厂商依赖性极高。

汽车电子对于半导体器件需求以 MCU、NOR Flash、IGBT 等为主。 传统汽车内部主要以 MCU 需求较高,包括动力控制、安全控制、发动机控制、底盘控制、车载电器等多方面。
汽车还包括电子控制单元 ECU、功率控制单元 PCU、电动汽车整车控制单元 VCU、混合动力汽车整车
HCU、电池管理系统 BMS 以及逆变器核心部件 IGBT 元件。传统汽车内部芯片
此外在以上相关系统和紧急刹车系统、胎压检测器、安全气囊系统等还需应用 NOR Flash 作为代码存储。 MCU 一般会用 8 英寸或 12 英寸 45nm~0.15μm 成熟制程, NOR Flash 一般会用 45nm~0.13μm 成熟制程,国内已基本实现量产。

智能驾驶所采用半导体器件包括高性能计算芯片及 ADAS 系统。 高性能计算芯片目前采用 12 英寸先进制程,而 ADAS 系统中的
(4)AI 与矿机芯片: 成长新动力,国内设计厂商实现突破AI 芯片与矿机芯片属于高性能计算,对于先进制程要求比较高。 在 AI 及
场景下,传统 CPU 算力不足,新架构芯片成为发展的新趋势。当前主要有延续传统架构的 GPU、 FPGA、ASIC(TPU、 NPU 等)芯片路径, 以及彻底颠覆传统计算架构,采用模拟人脑神经元结构来提升计算能力的芯片路径。 云端领域 GPU 生态领先,而终端场景专用化是未来趋势。
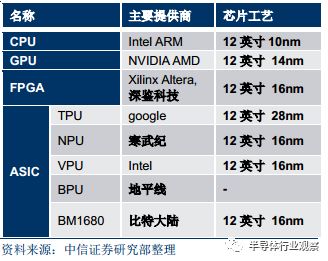
根据 NVIDIA 与 AMD 公布的技术路线 年 GPU 将进入 12nm/7nm 制程。 而目前 AI、矿机相关的 FPGA 及 ASIC 芯片也均采用了 10~28nm 的先进制程。国内厂商涌现了寒武纪、深鉴科技、地平线、比特大陆等优秀的 IC 设计厂商率先实现突破,而制造则主要是依靠台积电等先进制程代工厂商。

现阶段国产化程度低, 半导体产业实际依靠全球合作。 尽管我国半导体产业目前正处于快速发展阶段,但整体看来存在总体产能较低, 全球市场竞争力弱,核心芯片领域国产化程度低, 对国外依赖程度较高等现状。 我国半导体产业链在材料、设备、制造、设计等多个高端领域对国外高度依赖,实现半导体产业自主替代需经历较漫长道路。
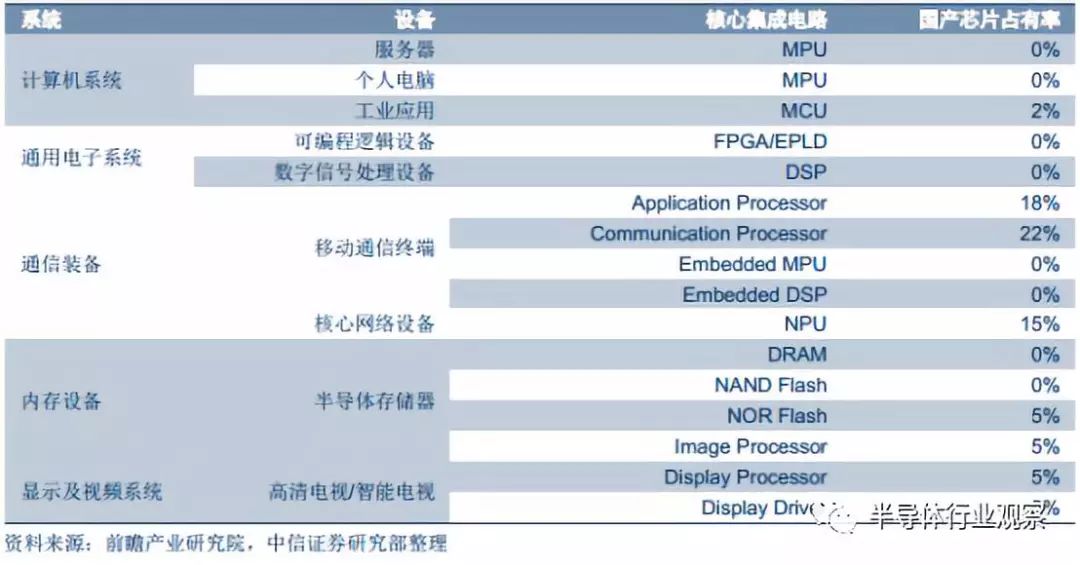
根据 IC Insight 多个方面数据显示, 2015 年我国集成电路企业在全球市场占有率仅有 3%,而美国、韩国、日本分别高达54%/20%/8%。 事实上,即便是美国、 韩国、 日本也无法达到半导体产业链 100%自产。例如在先进制程制造的核心设备
方面依然依赖荷兰 ASML 一家企业。更多参与全球分工,在此过程中逐渐提升国产化占比,是一条切实可行的半导体产业高质量发展道路。
中国大陆芯片下游需求端终端市场全备,供给端有望向中国大陆倾斜。 (1) 需求端:下游终端应用市场全备,规模条件逐步成熟。随着全球终端产品产能向中国转移,中国慢慢的变成了全球终端产品制造基地, 2017 年中国汽车、智能手机出货量占全球比重分别达 29.8%、33.6%。芯片需求全面涵盖硅基、化合物半导体市场,芯片市场空间巨大。(2)供给端:当前中国大陆产值规模居前的 IC 设计、晶圆代工、存储厂商寥寥数计,技术水平尚未达到领先水平,中高端芯片制造、化合物半导体芯片严重依赖进口。随着近些年终端需求随智能手机等产业链而逐渐转移至中国大陆,需求转移或拉动制造转移,下游芯片供给端随之开始转移至大陆。
国内政策加速半导体行业发展。 近年来我国集成电路扶持政策密集颁布, 融资、税收、补贴等政策环境一直在优化。尤其是 2014 年 6 月出台的《国家集成电路产业高质量发展推进纲要》,定调“设计为龙头、制造为基础、装备和材料为支撑”,以 2015、2020、2030 为成长周期全力推进我国集成电路产业的发展:目标到 2015 年,集成电路产业出售的收益超过 3500 亿元;到 2020 年,集成电路产业出售的收益年均增速超过 20%; 到 2030 年,集成电路产业链主要环节达到国际领先水平,一批企业进入国际第一梯队,实现跨越发展。
从发现到发展,从使用到创新,拥有这一段长久的历史。宰二十世纪初,就曾出现过点接触矿石检波器。1930年,氧化亚铜整流器制造成功并得到普遍应用,是
圆(晶片)的直径为4到10英寸(10.16到25.4厘米)的圆盘,在制作的完整过程中可承载非本征
产业链流程 /
制造工艺形成极微小的电路结构,再经切割、封装、测试成为芯片,大范围的应用到各类电子设备当中。
圆工艺 /
的市场格局 /
产业分类状况 /
产业链上游的重要环节,在芯片的生产制作的完整过程中起到关键性作用。根据芯片制作的完整过程划分,
拆解价值2000的JBL战鼓蓝牙音箱 最后完美配上了两颗BOSE的螺丝 #吃拆玩呗