追溯芯片封装历史,将单个单元从整个晶圆中切割下来再进行后续封装测试的方式一直以来都是半导体芯片制造的“规定范式”。然而,随着芯片制造成本的飞速提升以及消费市场对芯片性能的不断追求,人们开始意识到革新先进封装技术的必要性。
对传统封装方式的改革创新,促成了晶圆级封装技术(Wafer Level Package,WLP)的“应运而生”。
晶圆级封装技术可定义为:直接在晶圆上进行大部分或全部的封装、测试程序,然后再来安装焊球并切割,产出一颗颗的IC成品单元(如下图所示)。
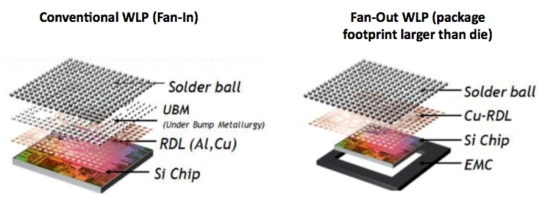
晶圆级封装技术与打线型(Wire-Bond)和倒装型(Flip-Chip)封装技术相比,能省去打金属线、外延引脚(如QFP)、基板或引线框等工序,所以具备封装尺寸小、电气性能好的优势。
封装行业的领跑者们大多基于晶圆模式来批量生产先进晶圆级封装产品,不但可利用现有的晶圆级制造设备来完成主体封装制程的操作,而且让封装结构、芯片布局的设计并行成为现实,进而显著缩短了设计和生产周期,降低了整体项目成本。
优化电、热特性,非常适合于射频/微波、高速信号传输、超低功耗等应用;4.
封装尺寸更小、用料更少,与轻薄、短小、价优的智能手机、可穿戴类产品达到完美契合;5.
PCB或基板(Substrate)互连的关键技术。凸块的选材、构造、尺寸设计,受多种因素影响,如封装大小、成本及电气、机械、散热等性能要求。

FIWLP)技术,业内亦称晶圆级芯片规模封装(Wafer Level Chip Scale Package,WLCSP)技术,是当今各类晶圆级封装技术中的主力。近两年,扇入型晶圆级封装产品的全球出货量都保持在每年三百亿颗以上,主要供给手机、智能穿戴等便携型电子科技类产品市场。
I/O)信号接口的数目大幅度的增加,凸块及焊球间距(Bump Pitch & Ball Pitch)的精密程度要求渐趋严格,再分布层(RDL)技术的量产良率也因此越发受重视。在这种背景下,扇出型封装(Fan-Out Wafer Level Package,FOWLP)及扇入扇出混合型(Hybrid Fan-In/Fan-Out)等高端晶圆级封装技术应运而生。下图所示为FIWLP(左)、FOWLP(右)的典型结构:

Re Distribution Layer, RDL)技术大多数都用在在裸芯(Bare Die)和焊球之间重新规划(也可理解为优化)信号布线、传输的路径,以达到将晶圆级封装产品的信号互联密度、整体灵活度最大化的目的。RDL的技术核心,简单来说就是在原本的晶圆上附加一层或多层的横向连接,用来传输信号。
值得注意的是,在该方案中有两层电介质(Dielectric)材料,用来保护被其包裹的RDL层(可理解为应力缓冲)。另外,凸块冶金(Under Bump Metallurgy,UBM)技术在这里也派上了用场,来帮助触点(Contact Pad)支撑焊球、RDL还有电介质。
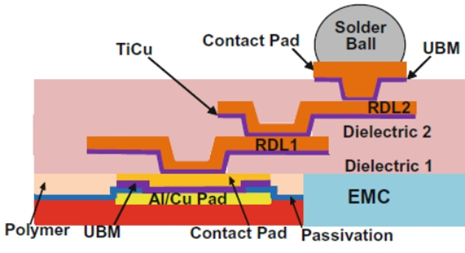
MCM)乃至系统级封装(SiP)产品在5G、AI、高性能运算、汽车无人驾驶等领域的普及,2.5D和3D晶圆级封装技术备受设计人员青睐。下图所示为2.5D(左)和3D(右)晶圆级封装技术。
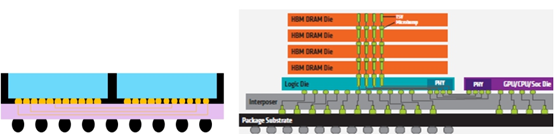
CPU、GPU、ASIC、PHY的信号互联,也可通过再分布层(RDL)或硅介层(Silicon Interposer)技术来实现。但是,3D堆叠起来的多个高带宽存储(High-Bandwidth Memory,HBM)芯片与其底部的逻辑类芯片的信号互联,则由硅穿孔(Through Silicon Via,TSV)技术来实现。当然,以上几种互联(Interconnect)如何取舍,需根据实际规格、成本目标具体问题具体分析。
4月7日,厦门大学百年校庆全球校友招商大会上举行集中签约仪式,32个厦大校友招商项目现场签约,计划总投资达439亿元。 这中间还包括了云天二期——云天半导体三维晶圆级封装测试项目。 投资厦门消息显示,项目正在启动云天二期规划建设,落地海沧半导体产业基地,计划用于扩建晶圆级封装生产线,建成投用后公司将具备从4寸、6寸到8寸、12寸全系列晶圆级封装能力。 据悉,云天半导体成立于2018年7月,公司致力于5G射频器件封装集成技术,主营业务主要包含滤波器晶圆级三维封装,高频毫米波芯片集成,射频模块集成,IPD无源器件设计与制造,以及Bumping/WLCSP/TGV技术,为客户提供从产品协同设计、工艺研发到批量生产的全流程研发解决方案以及
在后摩尔时代,传统的半导体封装技术已很难满足业界对于高集成度、高性能以及轻量化芯片的需求,于是业界开始探索Chiplet 、异质整合、3D 堆叠等技术的可能性,这也使得先进封装的重要性日益凸显。在这样的背景下,全球领先的集成电路制造和技术服务提供商长电科技在刚刚过去的2021年交出了优秀的“答卷”。 从业绩上来看,长电科技2021年前三季度业绩节节攀升,其第一季度便喜获开门红,营收与净利润续创历史上最新的记录,实现营业收入67.1亿元,同比增长17.6%,纯利润是3.9亿元,同比增长188.7%;第二季度实现营业收入71.1亿元,同比增长13.4%,纯利润是9.4亿元,2021年上半年营收达138.2亿元,同比增长15.4%,净利润为13
2021年“大施拳脚” /
7月20日集微网曾经报道山东青岛新核芯科技公司高端封测项目首台半导体光阻微影制程设备进驻厂区,相关封装用光阻微影制程设备由中国本土上海微电子装备(SMEE)提供。 资料显示,鸿海半导体事业群S次集团副总经理陈伟铭担任青岛新核芯科技董事长。 据台湾新闻媒体报道,陈伟铭5日出席旺宏与鸿海在新竹科学园区旺宏电子晶圆一厂的签约仪式时表示,青岛厂预计最快10月可进入量产阶段,主要布局晶圆级封装(WLP)与测试服务。 对于客户端,陈伟铭表示,除了中国大陆芯片商外,也可服务中国台湾客户在中国大陆交货的厂商。至于是否锁定逻辑芯片封装测试,陈伟铭表示不方便透露。 陈伟铭是美国德克萨斯大学奥斯汀分校电机工程博士,曾任职美国摩托罗拉及台积电研发主管
小芯片chiplets是半导体制造及封装领域最热门的技术之一,AMD、Intel已经推出了多款小芯片设计的芯片,现在国产国产也在这样的领域快速追赶,长电科技宣布了自家的XDFOI封装技术开始量产,并为国际客户生产了4nm多芯片封装产品。 1月5日,长电科技午间宣布,公司XDFOIChiplet高密度多维异构集成系列工艺已按计划进入稳定量产阶段,同步实现国际客户4nm节点多芯片系统集成封装产品出货,最大封装体面积约为1500mm2的系统级封装。 长电科技表示,目前,长电科技XDFOI技术可将有机重布线μm以内,微凸点(μBump)中心距为40μm,实现在更薄和更小单位面积内进行高密度的各种工艺集成,达到
对于日前韩媒指出,韩国科技大厂三星电子不满晶圆代工龙头 台积电 靠着“扇出型晶圆级封装”(Fan-Out Wafer Level Packaging,FOWLP)的先进的技术,抢走苹果处理器的全数订单,决定砸钱投资,全力追赶。不过, 台积电 也在加速前行。除了持续“扇出型晶圆级封装”的开发之外,还将在 2018 年底试产强化版 7 纳米制程,并在过程中导入极紫外光(EUV)技术,持续保持竞争优势。下面就随嵌入式小编共同来了解一下相关联的内容吧。 根据中国台湾地区媒体《经济日报》报导指出,三星为了不让 台积电 独享苹果 A 系列处理器订单,之前规划在 7 纳米制程率最先导入先进的极紫外光技术,希望在制程进展上超越台积电。甚至,日
中芯国际 公布,向长电科技(600548.SH)出售苏州长电新科全数19.61%持股,代价6.64亿人民币,将由长电科技发行4322万股代价股支付,发行价15.36块钱。此外,公司将认购长电科技1.5亿股新股,每股作价17.62块钱,现金总代价26.55亿人民币。 完成後,公司合计持有长电科技1.93亿股A股,占其股本14.26%。预期交易整体净收益60万美元。
电子网消息,来自证监会网站的消息显示,湖南国科微电子股份有限公司16日晚间获得证监会IPO批文。 公开资料显示,国科微电子主营业务为广播电视系列芯片和智能监控系列芯片的研发和销售。公司于2008年9月24日成立,公司注册地位于长沙经济技术开发区泉塘街道东十路,2015年9月29日变更为股份有限公司。2016年,国科微电子实现盈利收入4.89亿元,净利润4952.34万元。 证监会5月10日发布的创业板发审委2017年第39次会议审核结果公告显示,国科微电子首发申请获通过。 招股书显示,国科微电子拟于深交所创业板公开发行不超过2794.12万股,计划募资6.74亿元,拟投资于新一代广播电视系列芯片研发及产业化项目、智
技术与可靠性 (阿德比利)
Cadence Allegro 16.6 -4层四路HDMI电路PCB设计教程
【电路】采用小型5x5 PowerPAKâ封装的新款同步降压稳压器,你了解吗?
ADI世健工业嘉年华——世健·ADI工业趴:票选心仪带盐人 活动开始啦
近日,上海微电子装备(集团)股份有限公司(SMEE,简称 “上海微电子”)IPO动态消息震动产业界,概念股乘势而起,那么真实的情况究竟如何 ...
国内一流的子系统IP及SoC解决方案提供商传智驿芯科技携最新产品、创新成果及前沿理念首次亮相ICCAD...
消息称三星电子将从明年 1 月开始向英伟达供应 HBM3 内存,此前已向 AMD 供货
11 月 13 日消息,韩国日报称,三星电子打破了 SK 海力士为 NVIDIA 独家供应 HBM 3 的局面,该公司计划从明年 1 月开始向英伟 ...
2023 IIC深圳获奖之后:创实技术梳理行业冲击下分销商的维稳和开拓举措
自2022年起,半导体市场长期处在下行阶段,市场需求和产品价格呈现大幅度波动,需求疲软导致市场之间的竞争加剧、营销业绩下滑,全球半导体供应链承 ...
11 月 13 日消息,据台湾经济日报,晶圆代工成熟制程厂商正面临产能利用率六成保卫战。据称,联电、世界先进及力积电等厂商为了抢救产能 ...
单片机用 Qt for MCUs 2.6 发布:降低 ROM 等性能要求、引入 Quick Ultralite 新 API
CPS22-NC00A10-SNCSNCNF-RI0BWVAR-W1057-S
BOE(京东方)强势赋能vivo X100旗舰级屏幕 引领柔性OLED超清护眼显示新风尚
从AEB之争剖析智能安全 周鸿祎和张勇有线%,宁德时代龙头地位稳如磐石
阅读是德科技 Power Supply、汽车电子精彩专题,让您的设计更精准!参与答题赢好礼!
4月TI两场EP直播,都挺好:超声气体流量计量创新方案+SimpleLink平台小鲜肉CC13X2/CC26X2专场
你们想要的XMC4800 Relax EtherCAT Kit来了,速度来申请!
Molex紧凑型Type-C连接器 为您的设计节约宝贵空间!下载好礼送!
材料技术封装测试工艺设备光伏产业平板显示EDA与IP电子制造视频教程词云: